




Moldex3D芯片封装解决方案可协助用户建立微芯片网格,设计金线布局,以利进行微芯片封装的金线偏移与导线架偏移等分析计算。透过金线偏移计算可预测充填过程中塑料流动所造成的拖曳力对金线偏移量的影响,以及导致金线接触而产生的成品短路或金线断裂等问题。另外,导线架偏移分析也可评估导线架同样受到塑料流动拖曳力影响而产生的偏移行为。透过Moldex3D芯片封装解决方案,用户可完整仿真微芯片封装制程,在投入实际生产前即能提前预测各种成型瑕疵,藉由优化模具设计与加工条件以避免这些问题发生。
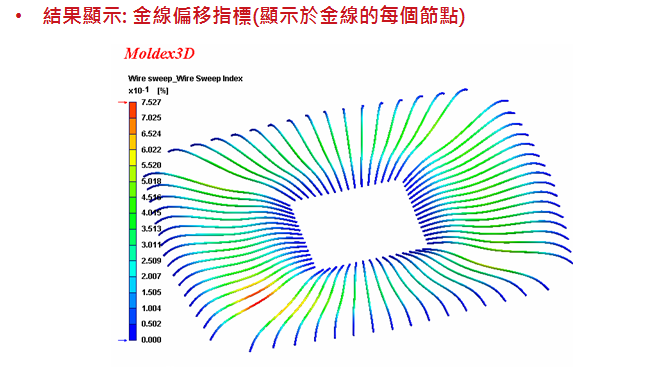
主要功能及技术特点:
1:预测流动波前推进情况,以检视模具充填过程。
2:预测三维惯性现象,以及成型过程中的转换变异。
3:预测短射、缝合线、包封等成型问题。
4:优化浇口设计,以平衡塑料流动行为,消除或最小化缝合线位置。
5:优化加工条件,如射出时间、固化时间等。
6:仿真多穴模型或群组模型的塑料射出充填过程。
7:预测金线密度对流动波前的影响。
8:预测流动拖曳力对金线偏移、导线架偏移的影响。